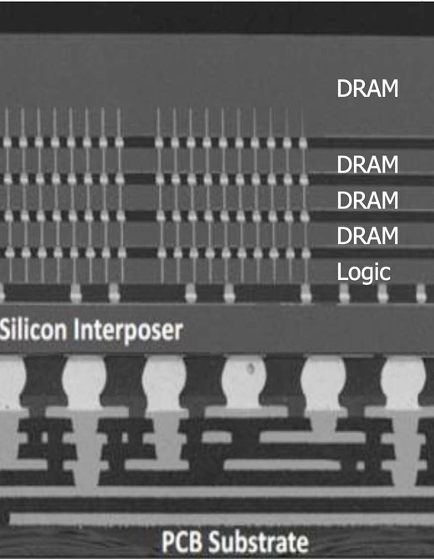
Through Silicon Vias, or TSVs, are a relatively new approach to reducing the size and volume of advanced packages. TSVs create connections from one chip to another through the use of a conductive channel from the front-side to the back-side of the semiconductor die. These structures are isolated from the semiconductor die itself through the use of a dielectric layer or a polymer-based insulator. In this course, we will provide an overview of the processing steps to create TSVs, discuss the use of backgrinding in conjunction with TSVs, and discuss the manufacturing challenges associated with TSVs. We will also discuss the bonding processes used to bond one chip to another using TSVs for the electrical connections. We will discuss the use of substrates and underfills in conjunction with TSVs. Finally, we will cover some of the reliability concerns associated with TSVs.